台風、予想通りの直撃でした。
久々に昼間に通り過ぎた台風だったので、家の中からたまに外を見て、すごい降ってるなー、こりゃあ大変だなー、と思いながら勉強してました。
・・・はい。昨日は結局一日「自宅待機」にしたのです。朝はぶっちゃけ、余裕で出社できたんですけど、「いきなり風が強くなるらしいんで危険なので」という理由で何とかなりました。ゆるい会社で良かったです。
さて、昨日の続きを少しスピードアップしてやっていきます。
IBM社レジスト特許、どこがすごいの?の後半です。
シリル化を利用した2層レジストには、大きな欠点がありました。
それは、シリル化によってある種の製品欠陥が出やすくなってしまう、ということです。
どのような欠陥なのでしょうか。
大きくわけて、2種類あります。
ひとつは、エッチングで削り取られるべきものが一部残渣として残ってしまうこと、(下記はイメージです)

もうひとつは、レジストが膨らんでしまい互いに接触し、ブリッジという糸引きの状態になったり、さらにひどくなってお互いが引っ付いてパターンが崩れてしまうことです。(下記の右側のような状態です)

残渣が発生するのは、本来エッチングで削られるべきところがシリル化で若干エッチング耐性を持ってしまったために、その分削られずに残ってしまうからです。
またレジストが膨らんでしまうのは、レジストが現像液を取り込んでしまうことによります。
ただ、このレジストの膨らみ(膨潤)とシリル化との関係がいまいちわかっていません。
前にこの記事にて少しだけ書いた通り、光の回り込みの性質で、ネガ型フォトレジストの未露光部が中途半端に露光されてしまうことで、膨潤が起きます。
シリル化処理によって、同じく未露光部(本来シリル化しなくてよい部分)もシリル化してしまうことで、現像液を取り込みやすい構造になった、ということかな、と推測しました。
この推測をもとに検証してみたのですが、それらしき根拠にはたどりつけませんでした。
「ケイ素が導入されることで、レジストが膨潤する」と書いてある明細書はあったのですが、なぜか、までは読み取れませんでした。(読んだ関連明細書:特開平6-104168、特開2000-199970)
これも「当業者の常識」ってやつでしょうか・・・この問題はペンディングにしています。
せっかく3層から2層に工程を減らしても、歩留まりが悪くなってしまっては意味がありません。
そこで、最後に登場する先行技術は、「典型的(typical)な2層構造」です。
先ほどのシリル化の2層構造との違いは、上層のレジスト層にすでにシリコンが含まれているかどうか、です。シリル化処理は行いません。

しかし、典型的と言われましても、何がどう典型的なのか良くわからないですよね。
今回の発明との相違点から「典型的」な部分を抜き取ると、
- 感光性化合物を含む、シリコン含有レジストを使用
- 従来の方法による現像を行う
この2点になるのかな、と思います。
典型的な2層構造に関しては欠点などが記載されていません。
今回の発明は、この典型的な2層構造よりも優れていますよ、ということを言いたいのでしょうけども、明確な記述がありません。なのでこれ以降、かなり推測の部分が多くなります。
今回の発明は、2層構造で使用されることが望ましいネガ型フォトレジストです。
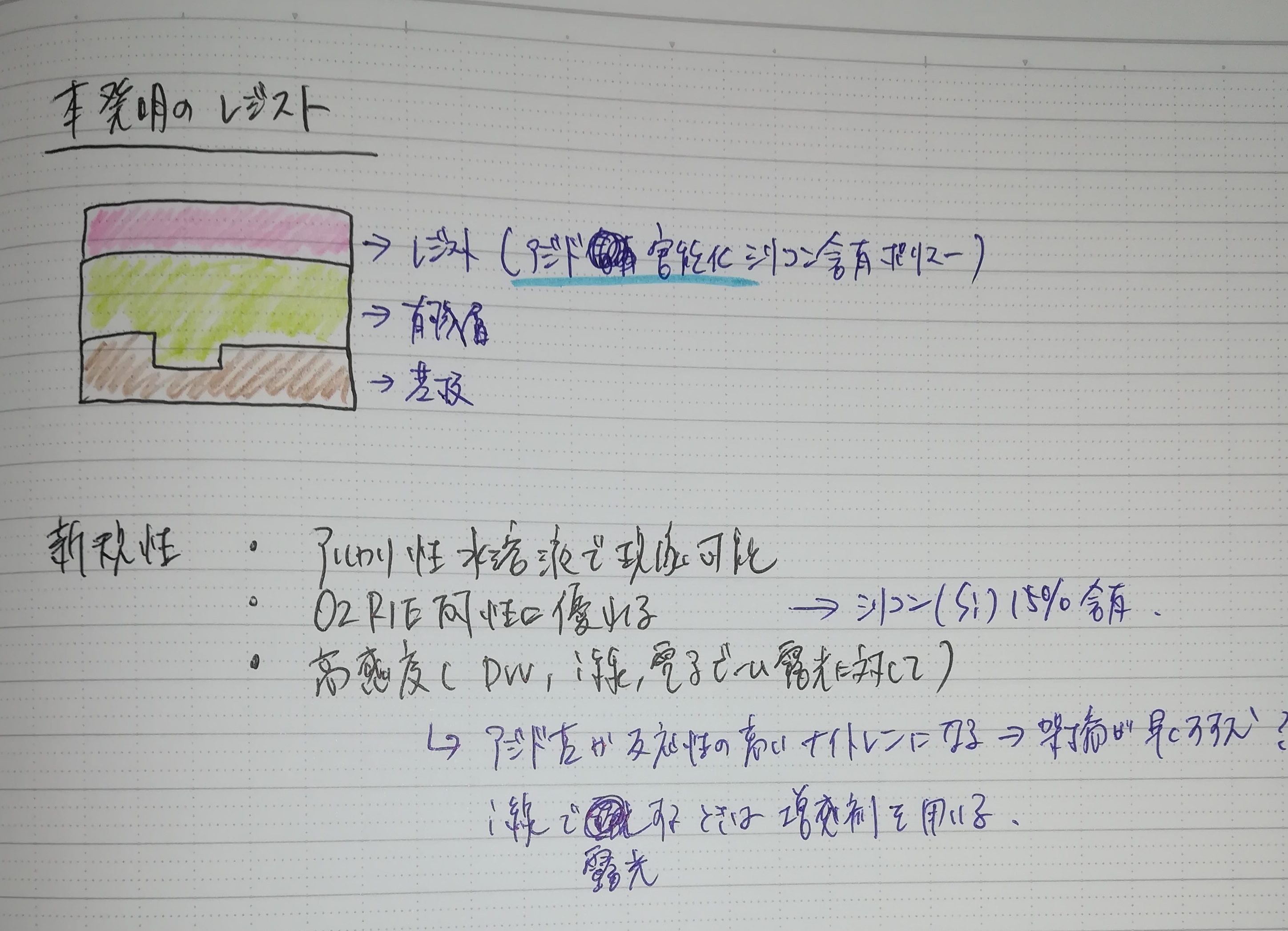
先ほどの「典型的な2層構造」と比較すると、レジストの材質が異なります。
「アジド官能化シリコン含有ポリマー」を含んでいます。
同じようにシリコン含有ではあるんですが、「アジド官能化」であることが従来技術との違いですね。
アジド基は光に反応して、ナイトレンという反応性の高い物質に分解されます。
このナイトレンの働きで、露光による架橋反応が早く進む、つまりレジストとしての感度が高くなるんですね。
より微細な加工ができるように、従来より波長が短い光源が使用されています。波長が短いと露光強度としては弱くなるため、レジスト側の感度を高めることが大切です。
明細書には、「結果として得られたネガ型レジスト材料は、アルカリ水溶液で現像可能であり、優れたO2RIE耐性及びエキシマレーザーの露光装置のスループット要件と適合する高感度を有する」とあります。
材料構成を最適にして、O2RIE耐性と感度を高めた、ということですね。
最後にもう一つ先ほどからチラチラと見えている言葉、「アルカリ水溶液で現像可能」について触れておきます。
これも、まだすっきり理解できていない項目です。
これも今回の発明の新規性の一つになると思うのですが、従来どうだったのか、またアルカリ水溶液で現像できると何が良いのか、までは書かれていないんですよね。(常識ってことですよね)
wikipediaのフォトレジストの項目には下記の記載がありました。
ネガ型は露光されると現像液に対して溶解性が低下し、現像後に露光部分が残る。現像液には多くが有機溶剤を使用しており、扱いや環境の面でポジ型に対して不利がある。また現像時に溶剤がレジストを膨潤させることから微細配線への対応が難しくなる。
有機溶剤というと、トルエンとかキシレンとか、揮発すると有害なガスを発生して取扱に注意が必要なものが多いので、それらを使わないことで、環境の面や作業性の面から言って有利になるということでしょうか。
今回の発明で使用するアルカリ水溶液は、テトラメチルアンモニウムヒドロキシド(TMAH)です。
現像液と言えばこれ!というくらいメジャーなもののようですが、有機溶剤であることには変わりないですよね。現像後にベークしたら熱で分解し残留しないので使いやすいということでしょうか。
こうやって書いてみると、ああ、ここの調査が足りなかったのか、ここがわかってなかったのか、ということが本当によくわかります。
まとめと言いつつあんまりまとまってないんですが、ここまでにします。
ペンディングにした部分は今後明細書を読んでいったら、あーそっか、とわかってくるかもしれません。
ということで、ここからは「はじめての半導体プロセス (現場の即戦力)」を読みつつ、明細書をガンガン読んでいきます。
9/4(火)の学習記録
学習時間:13h30m
項目: レジスト特許のまとめ つづき
目標: 2h 実績:10h10m
メモ:レジスト(シリル化・膨潤)明細書3件、
ブログの時間の半分(40分)含む
項目: 「はじめての半導体プロセス」を読む
目標: 5h 実績:3h20m
9/5(水)の学習計画
項目: 「はじめての半導体プロセス」+関連する明細書を読む
目標: 6h30m










